| Однокристальные
устройства, изготовленные по технологии
“кремний на изоляторе” (SOI), обладают
преимуществами, связанными с работой на
диэлектрической подложке из
высококачественного кремния. Технология SOI уже
получила признание у разработчиков цифровой
логики, SRAM и DRAM, и воспринимается ими как наиболее
перспективная технология ближайшего будущего.
Если технология SOI будет использоваться для
создания однокристальных устройств, то
потребуется соответствующее решение задачи
построения энергонезависимой памяти на базе
этой технологии, что и сделали представители
подразделения NVM Technology Centre компании Motorola [6],
разработав SOI сдвоенные поликремниевые ячейки
памяти EEPROM.
Рис. 1. Структура ячейки флэш-памяти, изготовленной по технологии SOI В то же время, успешная
разработка ячеек EEPROM потребовала создания
специальных высоковольтных формирующих
устройств. На рис. 1 схематически
показана структура ячейки флэш-памяти EEPROM на
базе одного транзистора с самосовмещённым
затвором, имеющего туннельный оксидный слой
толщиной 95 A. Тело ячейки остается полностью
“плавающим”. Ячейка SOI использует
туннелирование Фоулера-Нордхейма как для записи,
так и для стирания. Во время записи в ячейку
низкого логического уровня происходит
туннелирование электронов от плавающего затвора
к стоку, последний при этом не перекрывается
плывущим затвором. Запись завершается
туннелированием от канала до плавающего затвора.
При этом стоит отметить преимущества, которые
обеспечивает использование технологии SOI по
сравнению с КМОП-устройствами на монолитных
подложках. Для функционирования
монолитных устройств необходима организация
структуры из трёх карманов, которая позволяет
сохранять низкий уровень на отрицательном
p-кармане в процессе программирования. В
противоположность этому, плавающее тело
SOI-устройства программируется отрицательным
напряжением смещения, приложенным к истоку,
который после этого переводит плавающее тело в
отрицательное состояние. Кроме того,
технологический процесс SOI имеет количество
этапов на один меньшее, чем КМОП- процесс. Во всех других отношениях
характеристики SOI-устройств соответствуют
КМОП-устройствам на монолитных подложках. При
записи у SOI несколько меньше напряжение VT при
числе циклов записи/стирания 105 по сравнению с
КМОП-устройствами. Предположительно, это
происходит из-за инжекции большего числа
электронов или меньшего числа “дырок” при
приложении отрицательного напряжения к телу
ячейки во время программирования. Проблема увеличения
напряжения пробоя SOI-устройства при низком
напряжении смещения на за-творе с 5 В до более чем
10 В, которая наблюдалась в КМОП-устройствах, была
решена созданием структуры, где исток
электрически привязан к телу ячейки. В такой
структуре используется исток, состоящий из
чередующихся дополнительных областей с
проводимостью n- и p-типа. Каждое отдельное
устройство представляет собой набор
параллельных структур исток–сток (рис. 2), где
области с проводимостью n- и p-типа связаны единым
истоковым выводом.
Рис. 2. Структура с привязанным к телу ячейки истоком позволяет достичь большего напряжения пробоя для SOI-устройствОбласти с проводимостью p-типа располагаются под затвором и образуют канал для протекания тока исток–сток. Такая структура обеспечивает требуемое напряжение пробоя большее 10 В и по характеристикам соответствует большинству МОП-устройств с каналом n-типа. Технология "Кремний на изоляторе" Монолитные кремниевые слои имеют
такие недостатки, как паразитные электрические
цепи, возникающие вследствие большой емкости
изолирующего перехода. Причем с уменьшением
размеров приборов трудности, возникающие при
решении этой проблемы возрастают. Как разновидность метода КНИ используется технология кремний на сапфире (КНС). В КНС технологии в качестве подложки используется сапфир - Al2O3. На него эпитаксиальным способом наносят слои полупроводников, например, кремния или арсенида галлия. Процесс является гетероэпитаксиальным, так как материал слоя и подложки отличаются (например, AlxGa1-x выращивается на GaAs). . В качестве кремнийсодержащего соединения наиболее часто выбирают силан, газом-носителем служит водород. При нагревании происходит пиролиз силана: SiH4 Основные параметры КНС следующие:
Поскольку материалы подложки и полупроводника не являются "родственными" и имеет место автолегирование Al из подложки, то полупроводник обладает высокой плотностью дефектов. Эти дефекты обуславливают значительные токи утечки p-n переходов, малое время жизни и низкую подвижность носителей. Поэтому КНС технологии можно использовать только при производстве приборов, работающих на основных носителях, например, КМОП схем. Для уменьшения автолегирования Al из подложки полупроводники наносят молекулярно-лучевым способом, имеющим низкие температуры процесса. В КНИ технологии в качестве диэлектрической
подложки используется слой SiO2.
Отметим, что кремний, полученный по КНИ технологии, имеет меньшую плотность дефектов, чем КНС кремний. Развитие КНИ технологии может послужить толчком в создании ИС нового поколения - трехмерных интегральных схем.
|


 Si+2H2.
Si+2H2. Возможен
другой вариант. В технологическом цикле
осуществляют процесс рекристаллизации аморфного
кремния, осажденного на двуокись кремния (см. рис. 1). Рекристаллизация производится
за счет локального нагрева участка поверхности
лазером или электронным лучом. Слой
монокристаллического кремния, граничащий
поликристаллом или аморфным слоем Si, играет роль
затравки, а SiO2 используется для уменьшения
загрязнений в кремнии.
Возможен
другой вариант. В технологическом цикле
осуществляют процесс рекристаллизации аморфного
кремния, осажденного на двуокись кремния (см. рис. 1). Рекристаллизация производится
за счет локального нагрева участка поверхности
лазером или электронным лучом. Слой
монокристаллического кремния, граничащий
поликристаллом или аморфным слоем Si, играет роль
затравки, а SiO2 используется для уменьшения
загрязнений в кремнии. 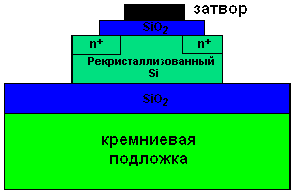 Существует
и третий способ, который можно использовать
для изготовления МОП транзистора (см. рис. 2). На
окисленную подложку монокремния наносят
островки поликремния, которые впоследствии
рекристаллизуют.
Существует
и третий способ, который можно использовать
для изготовления МОП транзистора (см. рис. 2). На
окисленную подложку монокремния наносят
островки поликремния, которые впоследствии
рекристаллизуют.