13. Осаждение тонких плёнок в вакууме.
Проводники на поверхности кристалла полупроводниковой ИМС, а также пассивные элементы гибридно-пленочных микросхем создаются на основе тонких плёнок толщиной 0,1÷2 мкм. Высокая точность по толщине и химическая чистота для тонких плёнок могут быть достигнуты только при выращивании слоя из атомарного (молекулярного) потока. Такие условия можно создать в вакууме либо при нагреве, испарении и конденсации материала, либо при бомбардировке твёрдого образца материала (мишени) ионами инертного газа, распыления его в атомарный (молекулярный) поток и конденсации на поверхности изделия.
Процессы первого рода получили название "термическое вакуумное напыление" (ТВН), второго рода - "распыление ионной бомбардировкой" (РИБ).
| 13.1. Термическое вакуумное напыление. |
| 13.2. Распыление ионной бомбардировкой. |
13.1. Термическое вакуумное напыление.
 Основными элементами установки вакуумного напыления, упрощенная схема которой представлена на рис. 21, являются: 1 - вакуумный колпак из нержавеющей стали; 2 - заслонка; 3 - трубопровод для водяного нагрева или охлаждения колпака; 4 - игольчатый натекатель для подачи атмосферного воздуха в камеру; 5 - нагреватель подложки; 6 - подложкодержатель с подложкой, на которой может быть размещен трафарет; 7 - герметизирующая прокладка из вакуумной резины; 8 - испаритель с размещённым в нём веществом и нагревателем (резистивным или электронно-лучевым).
Основными элементами установки вакуумного напыления, упрощенная схема которой представлена на рис. 21, являются: 1 - вакуумный колпак из нержавеющей стали; 2 - заслонка; 3 - трубопровод для водяного нагрева или охлаждения колпака; 4 - игольчатый натекатель для подачи атмосферного воздуха в камеру; 5 - нагреватель подложки; 6 - подложкодержатель с подложкой, на которой может быть размещен трафарет; 7 - герметизирующая прокладка из вакуумной резины; 8 - испаритель с размещённым в нём веществом и нагревателем (резистивным или электронно-лучевым).
Процесс проведения операции вакуумного напыления включает в себя выполнение следующих действий. В верхнем положении колпака с подложкодержателя снимают обработанные подложки и устанавливают новые. Колпак опускают и включают систему вакуумных насосов (вначале для предварительного разрежения, затем высоковакуумный). Для ускорения десорбции воздуха с внутренних поверхностей и сокращения времени откачки в трубопровод подают горячую проточную воду. По достижении давления внутри камеры порядка 10-4 Па (контроль по манометру) включают нагреватели испарителя и подложек. По достижении рабочих температур (контроль с помощью термопар) заслонку отводят в сторону и пары вещества достигают подложки, где происходит их конденсация и рост плёнки. Система автоматического контроля за ростом плёнки фиксирует либо толщину плёнки (для диэлектрика плёночных конденсаторов), либо поверхностное сопротивление (для резисторов), либо время напыления (проводники и контакты, защитные покрытия). Вырабатываемый при этом сигнал об окончании напыления после усиления воздействует на соленоид заслонки, перекрывая ею поток пара. Далее отключают нагреватели испарителя и подложек, выключают систему откачки, а в трубопровод подают холодную проточную воду. После остывания подколпачных устройств через натекатель плавно впускают атмосферный воздух. Выравнивание давлений внутри и вне колпака даёт возможность поднять его и начать следующий цикл обработки.
Процесс термического вакуумного напыления характеризуется температурой на испарителе t°ис, давлением воздуха в рабочей камере P0, температурой нагрева подложек t°п. Температура нагрева вещества в испарителе (t°ис) должна обеспечивать достаточно высокую интенсивность испарения, чтобы время напыления пленки не превышало 1-2 минут. В то же время чрезмерно высокая интенсивность приводит к образованию мелкозернистой неустойчивой структуры в плёнке, о чём будет сказано ниже.
Интенсивность испарения удобно характеризовать упругостью пара (давлением пара в состоянии насыщения) PS. Упругость пара для данного вещества зависит только от температуры:
 | (42) |
где А и В - коэффициенты, характеризующие род материала (табл. 6); Т- абсолютная температура вещества, К.
Таблица 6. Температуры плавления и испарения некоторых элементов.

* Значения в скобках для твердого состояния.
** Рекомендуется испарение электронно-лучевым нагревом или распыление ионной бомбардировкой.
Оптимальной интенсивностью испарения принято считать интенсивность, при которой упругость пара составляет ~1,3 Па. Соответствующая этой упругости температура испарения называется условной и может быть вычислена из (42). Так, для алюминия она равна 1150°С, для хрома - 1205°С, для меди - 1273°С, для золота - 1465°С и т.д.
Низкое давление воздуха Р0 в рабочей камере необходимо для:
- обеспечения свободной диффузии атомов вещества испарителя в объём рабочей камеры;
- прямолинейного движения атомов вещества без столкновения с молекулами остаточного воздуха и бесполезного рассеивания материала в объёме камеры;
- исключения химического взаимодействия напыляемого вещества с молекулами воздуха.
Перечисленные условия обеспечиваются при остаточном давлении Р0£10-4 Па. Такой вакуум сравнительно легко достигается с помощью форвакуумного механического и высоковакуумного диффузионного насосов, включённых последовательно.
Температура подложки в процессе осаждения оказывает существенное влияние на структуру плёнки, а, следовательно, и на стабильность её электрофизических свойств в процессе эксплуатации.
Атомы вещества поступают на подложку с энергией кТ (к=8,63×10-5 эВ/К- постоянная Больцмана; Т- абсолютная температура) и скоростями порядка 1000 м/с. Часть энергии при этом передаётся поверхностным атомам подложки, а остаточная энергия позволяет им некоторое время мигрировать в поверхностном потенциальном поле. Доля остаточной энергии тем выше, чем выше температура подложки. В процессе миграции атом может либо покинуть подложку (на потенциальном бугре поля), либо частично погасить энергию, вступив во взаимодействие с другим мигрирующим атомом. Полностью потерять способность мигрировать и закрепиться на нагретой подложке (конденсироваться) может лишь многоатомная группа, которая становится одним из центров кристаллизации. При невысокой плотности потока атомов, т.е. умеренной температуре на испарителе, число центров кристаллизации на единицу площади невелико и к моменту образования сплошной плёнки вокруг них успевают вырасти крупные кристаллы.
Снижение температуры подложки и повышение плотности потока приводит к более раннему образованию центров кристаллизации, увеличению их числа на единицу площади и формированию мелкокристаллической структуры. В процессе эксплуатации электронной аппаратуры, когда она подвергается периодическим циклам нагрева и медленного охлаждения мелкокристаллическая структура постепенно рекристаллизуется в крупнокристаллическую. Электрофизические свойства при этом необратимо изменяются, происходит "старение" плёнки. В резистивных плёнках, например, наблюдается со временем уменьшение удельного сопротивления.
Итак, для формирования тонких плёнок, стабильных в процессе эксплуатации, необходимо подложку нагревать и не форсировать процесс напыления за счёт повышения температуры на испарителе.
В производстве тонкоплёночных структур, как и в случае полупроводниковых, используются групповые подложки. Групповые подложки имеют прямоугольную форму с размерами 60х48 мм или 120х96 мм, изготовлены из изолирующего материала (ситалл, поликор, стекло) и рассчитаны на одновременное изготовление до нескольких десятков идентичных модулей. Таким образом, свойства напыленной плёнки должны быть одинаковы на всей площади групповой подложки.
В первом приближении поток атомов от испарителя к подложке представляет собой расходящийся пучок и поэтому плотность потока в плоскости подложки не равномерна: в центре подложки она максимальна и убывает от центра к периферии. Это означает, что при напылении плёнки на неподвижную подложку в центральной области подложки образуется более толстая плёнка, нежели на краях подложки. Например, резисторы, сформированные в центральных модулях, будут иметь заниженные сопротивления по сравнению с аналогичными резисторами периферийных модулей.
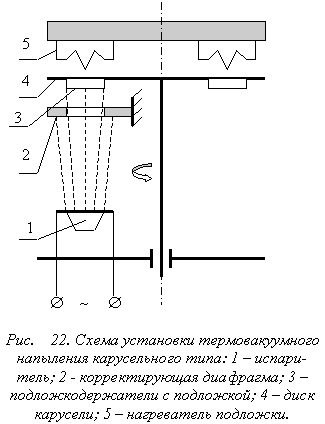 С учётом изложенного производственные установки термовакуумного напыления снабжены вращающимися устройствами (дисками, барабана-ми), несущими несколько подложек (6, 8 или 12). Подложки последовательно и многократно проходят над неподвижным испарителем (рис. 22), постепенно набирая необходимую толщину плёнки. В результате центральный "холм", который мог бы образоваться, на неподвижной подложке, размывается в "хребет", вытянутый в направлении движения подложки. Для выравнивания толщины плёнки в поперечном направлении применяют корректирующую диафрагму, устанавливаемую между испарителем и подложкой в непосредственной близости от нее. Профиль диафрагмы рассчитывается на основании исследования рельефов плёнки, получаемых при напылении на неподвижную и движущуюся подложки. В результате различия времени облучения центральной и периферийной зон подложки равномерность толщины плёнки на всей площади групповой подложки повышается и находится в пределах ±2% (для подложек 60х48 мм).
С учётом изложенного производственные установки термовакуумного напыления снабжены вращающимися устройствами (дисками, барабана-ми), несущими несколько подложек (6, 8 или 12). Подложки последовательно и многократно проходят над неподвижным испарителем (рис. 22), постепенно набирая необходимую толщину плёнки. В результате центральный "холм", который мог бы образоваться, на неподвижной подложке, размывается в "хребет", вытянутый в направлении движения подложки. Для выравнивания толщины плёнки в поперечном направлении применяют корректирующую диафрагму, устанавливаемую между испарителем и подложкой в непосредственной близости от нее. Профиль диафрагмы рассчитывается на основании исследования рельефов плёнки, получаемых при напылении на неподвижную и движущуюся подложки. В результате различия времени облучения центральной и периферийной зон подложки равномерность толщины плёнки на всей площади групповой подложки повышается и находится в пределах ±2% (для подложек 60х48 мм).
Технические характеристики установки типа УВН-71П-3 следующие:

13.2. Распыление ионной бомбардировкой.
Термическое вакуумное напыление имеет ряд недостатков и ограничений, главные из которых следующие:
- Напыление плёнок из тугоплавких материалов (W, Mo, SiO2, Al2O3 и др.) требует высоких температур на испарителе, при которых неизбежно "загрязнение" потока материалом испарителя.
- При напылении сплавов различие в скорости испарения отдельных компонентов приводит к изменению состава плёнки по сравнению с исходным составом материала, помещённого в испаритель.
- Инерционность процесса, требующая введения в рабочую камеру заслонки с электромагнитным приводом.
- Неравномерность толщины плёнки, вынуждающая применять устройства перемещения подложек и корректирующие диафрагмы.
Первые три недостатка обусловлены необходимостью высокотемпературного нагрева вещества, а последний - высоким вакуумом в рабочей камере.
Процесс распыления ионной бомбардировкой является "холодным" процессом, т.к. атомарный поток вещества на подложку создаётся путём бомбардировки поверхности твёрдого образца (мишени) ионами инертного газа и возбуждения поверхности атомов до энергии, превышающей энергию связи с соседними атомами. Необходимый для этого поток ионов создаётся в электрическом газовом разряде, для чего давление газа в рабочей камере должно быть в пределах 0,1×10 Па, т.е. на несколько порядков более высокое, чем в камере установки термовакуумного напыления.
Последнее обстоятельство приводит к рассеиванию потока атомов с мишени и повышению равномерности толщины осаждаемых плёнки до ±1% , причём без применения дополнительных устройств.
Катодное распыление.
Катодное распыление - одна из разновидностей распыления ионной бомбардировкой постепенно вытесняется более совершенными процессами высокочастотного и магнетронного распыления. Однако, будучи относительно простым и в то же время содержащим все основные черты этой группы процессов, оно представляет собой наиболее удобную форму для изучения процессов этого вида распыления вообще. На рис. 23 представлена схема рабочей камеры установки катодного распыления. 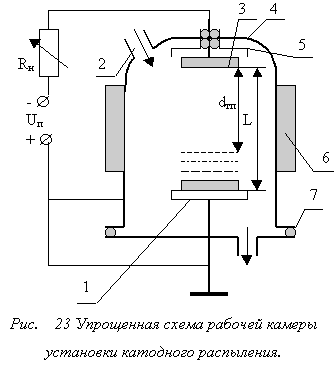 Основными элементами камеры являются: 1 - анод с размещенными на нём подложка- ми; 2 - игольчатый натекатель, обеспечивающий непрерывную подачу аргона; 3 - катод - мишень из материала, подлежащего распылению и осаждению; 4 - вакуумный колпак из нержавеющей стали; 5 - экран, охватывающий катод с небольшим зазором и предотвращающий паразитные разряды на стенки камеры; 6 - постоянный электромагнит, удерживающий электроны в пределах разрядного столба; 7 - герметизирующая прокладка. Из рис. 6.23 также видно, что питание осуществляется постоянным напряжением, и что нижний электрод с подложками заземлён и находится под более высоким потенциалом, чем катодмишень. Переменная нагрузка служит для регулирования тока разряда.
Основными элементами камеры являются: 1 - анод с размещенными на нём подложка- ми; 2 - игольчатый натекатель, обеспечивающий непрерывную подачу аргона; 3 - катод - мишень из материала, подлежащего распылению и осаждению; 4 - вакуумный колпак из нержавеющей стали; 5 - экран, охватывающий катод с небольшим зазором и предотвращающий паразитные разряды на стенки камеры; 6 - постоянный электромагнит, удерживающий электроны в пределах разрядного столба; 7 - герметизирующая прокладка. Из рис. 6.23 также видно, что питание осуществляется постоянным напряжением, и что нижний электрод с подложками заземлён и находится под более высоким потенциалом, чем катодмишень. Переменная нагрузка служит для регулирования тока разряда.
 На рис. 24 представлена упрощённая структура разряда и распределение потенциала вдоль разряда, а также типы частиц, участвующих в процессе.
На рис. 24 представлена упрощённая структура разряда и распределение потенциала вдоль разряда, а также типы частиц, участвующих в процессе.
Разряд разделён на две зоны: тёмное катодное пространство и светящаяся область. На тёмное катодное пространство приходится основное падения напряжения. Здесь заряженные частицы разгоняются до энергии, достаточной, чтобы ионы, бомбардируя катод-мишень, освобождали поверхностные атомы и электроны (если мишень из проводящего материала), а электроны - на границе тёмного катодного пространства ионизировали молекулы аргона. При ионизации образуется ион аргона, который, ускоряясь, стремится к мишени, и электрон, который, как и "отработанный" ионизирующий электрон, дрейфует к аноду в слабом поле светящейся области. Освобожденный с поверхности мишени атом вещества, преодолевая столкновения с молекулами и ионами аргона, достигает поверхности подложки. При этом непрерывный поток ионов бомбардирует мишень, и непрерывный поток атомов вещества движется к подложке.
Режимы катодного распыления.
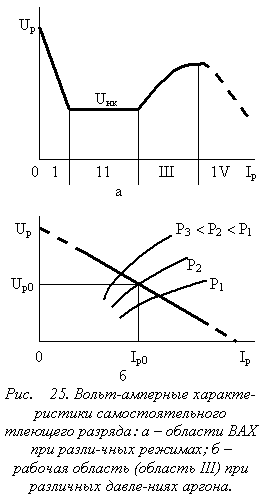 На рис. 25а приведена вольт-амперная характеристика разряда. При подаче постоянного напряжения в несколько киловольт происходит пробой межэлектродного промежутка, быстрое нарастание тока и падение напряжения в разряде (область зажигания разряда I). При увеличении тока разряда за счёт уменьшения сопротивления Rн площадь катода-мишени, покрытая разрядом, возрастает, плотность разрядного тока и напряжение на разряде остаются постоянными и невысокими, а скорость распыления мала (область нормально тлеющего разряда II). В области III вся площадь мишени покрыта разрядом, и увеличение разрядного тока приводит к повышению плотности разрядного тока, напряжения на разряде и скорости распыления. Область Ш, называемая областью аномально тлеющего разряда, используется в качестве рабочей области в процессах катодного распыления. Для предотвращения перехода в область дугового разряда (область IV) предусмотрены интенсивное водяное охлаждение мишени и ограничение источника питания по мощности.
На рис. 25а приведена вольт-амперная характеристика разряда. При подаче постоянного напряжения в несколько киловольт происходит пробой межэлектродного промежутка, быстрое нарастание тока и падение напряжения в разряде (область зажигания разряда I). При увеличении тока разряда за счёт уменьшения сопротивления Rн площадь катода-мишени, покрытая разрядом, возрастает, плотность разрядного тока и напряжение на разряде остаются постоянными и невысокими, а скорость распыления мала (область нормально тлеющего разряда II). В области III вся площадь мишени покрыта разрядом, и увеличение разрядного тока приводит к повышению плотности разрядного тока, напряжения на разряде и скорости распыления. Область Ш, называемая областью аномально тлеющего разряда, используется в качестве рабочей области в процессах катодного распыления. Для предотвращения перехода в область дугового разряда (область IV) предусмотрены интенсивное водяное охлаждение мишени и ограничение источника питания по мощности.
На рис. 25,б выделена рабочая область III ВАХ. Крутизна характеристики в этой области зависит от давления рабочего газа, в нашем случае аргона. Рабочая точка, характеризующая режимы обработки - давление газа Р, ток Jp и напряжение Up разряда, лежит на нагрузочной характеристике источника питания:
 | (43) |
где Uп - напряжение питания.
С другой стороны, скорость распыления мишени W[г/см2×с]
 | (44) |
где С - коэффициент, характеризующий род распыляемого материала и род рабочего газа; Uнк - нормальное катодное падение напряжения (область II ВАХ); jp - плотность разрядного тока; dTП - ширина тёмного катодного пространства.
Из (44) следует, что максимальная скорость распыления достигается при максимальной мощности, выделяемой в разряде. Согласно нагрузочной характеристике (43):
 | (45) |
Максимум этой функции определяет оптимальные значения тока Jp0 и напряжения  и
и  . При этом однозначно определяется оптимальное значение давления рабочего газа. Выбор значений Un и Rн должен, как было сказано, предотвращать переход в область дугового разряда, при котором наблюдается выброс с мишени крупных частиц и осаждение тонкой, однородной по толщине плёнки становится невозможным.
. При этом однозначно определяется оптимальное значение давления рабочего газа. Выбор значений Un и Rн должен, как было сказано, предотвращать переход в область дугового разряда, при котором наблюдается выброс с мишени крупных частиц и осаждение тонкой, однородной по толщине плёнки становится невозможным.
Другие виды распыления.
К ограничениям и недостаткам процесса катодного распыления относятся
- Возможность распыления только проводящих материалов, способных эмиттировать в разряд электроны, ионизирующие молекулы аргона и поддерживающие горение разряда.
- Малая скорость роста плёнки (единицы нм/с) из-за значительного рассеивания распыляемых атомов материала в объёме рабочей камеры.
Первый недостаток, имеющий характер ограничения, преодолевается в процессах высокочастотного распыления. При замене постоянного напряжения на переменное диэлектрическая мишень становится конденсатором и подвергается бомбардировке ионами в отрицательный полупериод питающего напряжения. Иначе говоря, распыление мишени происходит не непрерывно, как при катодном распылении, а дискретно с частотой питающего напряжения (обычно 13,56 Мгц).
При высокой частоте и согласованным с ним расстоянием от мишени до подложек электроны, находящиеся в срединной части высокочастотного разряда, не успевают достигать электродов за время полупериода, они остаются в разряде, совершая колебательные движения и интенсивно ионизируя рабочий газ. Это обстоятельство позволяет снизить давление рабочего газа без снижения разрядного тока, т.к. степень ионизации заметно повышается (второй недостаток катодного распыления). Характерные режимы высокочастотного распыления: Р=0,5…5 Па; Jp=1…2 А; Up=1…2 кВ.
В установках магнетронного распыления (в частности ВЧ-магнетронного) приняты меры для дальнейшего, существенного снижения давления рабочего газа и повышения за счёт этого скорости осаждения плёнки. С этой целью на разрядный столб накладывается постоянное магнитное поле, вектор которого перпендикулярен вектору электрического поля. В результате движение электронов происходит по сложным (близким к циклоидам) траекториям, степень ионизации рабочего газа существенно повышается и это даёт возможность снизить давление газа, не снижая (и даже повышая) разрядный ток. Главный итог этих мер - повышение скорости роста плёнки до нескольких нм/с, что сравнимо со скоростями в процессах термического вакуумного напыления. Характерные режимы ВЧ-магнетронного распыления: Р=0,1…0,5 Па; Jp=2…4 А; Up=0,7…1 кВ.