17. Крепление подложек и кристаллов.
Метод крепления подложек и кристаллов на основании корпуса, а также кристаллов и других компонентов на подложках зависит от выбора материала присоединительного слоя - клея, стекла, припоя и т. д.
В свою очередь, материал присоединительного слоя должен обеспечивать эффективный отвод теплоты в подложку или корпус в зависимости от выделяемой мощности, хорошее согласование температурных коэффициентов расширения (ТКР) соединяемых элементов в широком диапазоне рабочих температур (обычно --60 ¸ +125°С), стойкость к динамическим воздействиям (с ускорением до 150g) в условиях воздействия вибраций и ударов. В отдельных случаях присоединительный слой должен быть электропроводным.
Отвод теплоты от кристалла (компонента) в полых корпусах осуществляется главным образом через присоединительный слой за счет механизма теплопроводности. Эффективность отвода теплоты зависит прежде всего от удельной теплопроводности материала присоединительного слоя, а также его геометрии - толщины и площади. Если считать кристалл и основание под ним изотермическими, а площадь слоя равной площади кристалла, то тепловой, поток через слой однороден и тепловое сопротивление слоя R [К/Вт]=h/(l s), где l - коэффициент теплопроводности материала слоя [Вт/(см*К)] (табл.); h - толщина слоя [см]; s - площадь слоя [см2].
Достаточно малые тепловые сопротивления (десятые доли К/Вт) имеют присоединительные слои на основе металлических припоев. Тепловое сопротивление спая на основе стекла лежит в пределах 60…200 К/Вт. Наибольшее сопротивление имеют клеевые соединения (вследствие малого коэффициента теплопроводности). Так как перегрев кристалла, т. е. перепад температур в системе "кристалл-основание", зависит от мощности, выделяемой кристаллом (D t°~RP), то присоединительные слои с большим тепловым сопротивлением могут применяться для компонентов, выделяющих малую мощность.
Различие температурных коэффициентов расширения кристалла (подложки) и основания в условиях нагрева или охлаждения вызывает в них внутренние напряжения (растягивающие или сжимающие) в зависимости от соотношения ТКР. Эти напряжения имеют максимальные значения на контактных поверхностях присоединительного слоя. При хорошей адгезии напряжения могут превысить предел прочности материала слоя на растяжение или сжатие, так как его прочность обычно ниже прочности соединяемых деталей. Например, слой стекла, имеющего высокую адгезию со многими материалами (до 100 МПа), плохо противостоит напряжениям растяжения.
Температурные деформации на границах слоя уменьшаются, если ТКР слоя имеет промежуточное значение между ТКР материалов соединяемых деталей (табл. 12). В этом случае слой выполняет роль своеобразного буфера. Наилучшие условия согласования возникают при плавном изменении состава (а следовательно, и ТКР) присоединительного слоя. Такие условия, в частности, возникают при пайке контактным плавлением.
При вибрациях, ударах и статических перегрузках на элементы конструкции микросхемы действуют распределенные нагрузки, причем пиковые значения результирующих сил определяются массой элемента и ускорением (F=mа). Эти силы в зависимости от направления стремятся сдвинуть или оторвать элемент. Благодаря малой массе, элементы микросхемы (включая подложку) хорошо противостоят действию статических перегрузок и одиночных ударов. Например, при действии ускорения 150g в плоскости керамической подложки размером 30х24 мм сдвиговое усилие имеет значение ~40 Н, а соответствующее напряжение в присоединительном слое ~60 кПа, что примерно в сто раз меньше предела прочности на сдвиг (адгезии) для соединений на основе современных клеев (единицы МПа).
Таблица 12. Значения коэффициента теплопроводности l[Вт/(см*К)] и температурного коэффициента расширения a[10-6*К-1] некоторых материалов.

Более существенное влияние на прочность соединения оказывают длительные вибрационные воздействия (частота 5…5000 Гц при ускорениях до 40g), которые могут привести к усталостным разрушениям в слое. Развитию усталостных разрушений способствуют температурные деформации, возникающие при изменении температуры во время эксплуатации, а также остаточные температурные деформации в результате нагрева в процессе выполнения операции соединения. Наименее стойкими к вибрационным воздействиям являются соединения стеклом, обладающие хрупкостью и пониженной прочностью на растяжение.
Процесс крепления подложек и кристаллов можно условно представить в виде последовательности этапов:
1) подготовка поверхности основания и нанесение присоединительного материала (клея, стекла, припоя);
2) ориентированная установка кристалла (подложки) на основание;
3) собственно присоединение, которое в общем случае выполняется под давлением и с нагревом.
Наиболее точным и производительным способом нанесения присоединительного материала, обладающего свойствами пасты (клей, суспензия стекла, лудящая паста), является сеткографический способ, который, кроме того, позволяет обеспечить достаточно точную дозировку присоединительного материала, а следовательно, высокую воспроизводимость геометрических размеров соединения. Конструкция корпуса микросхемы должна при этом обеспечивать возможность плотного прилегания сетки к основанию.
Ориентация кристалла непосредственно на основании нежелательна, поэтому кристаллы должны быть предварительно ориентированы и уложены в кассеты, откуда вакуумным пинцетом их переносят к месту соединения.
Собственно присоединение можно выполнять индивидуально для каждого кристалла на специальных технологических установках (обычно при соединении пайкой) или групповым способом в кассетах под необходимым давлением с общим нагревом в печах или термостатах (соединения стеклом или склеиванием).
Клеевые соединения используют для микросхем и компонентов пониженной мощности. Технология клеевых соединений проста и может быть применена для широкого круга материалов (с использованием клеев на эпоксидной основе) и диапазона рабочих температур (-60¸+150°C, кратковременно до 450°С). Клеевые соединения стойки к вибрациям.
Основным недостатком эпоксидных смол является высокий ТКР и пониженная теплопроводность, поэтому клеи на основе этих смол всегда содержат наполнители (минеральные или металлические), снижающие значение a и увеличивающие l. Клеевые соединения характеризуются наличием внутренних напряжений, которые возникают вследствие первичной усадки при полимеризации (уплотнение структуры), усадки при охлаждении (при горячем отверждении), разницы ТКР соединяемых деталей и клея.
При склеивании большинство клеев допускают варьирование температуры и времени в широких пределах, причем при повышении температуры время отверждения клея быстро уменьшается. Режим холодного отверждения осуществляется при комнатной температуре, но требует длительной выдержки (до 48 ч). Поэтому склеивание, как правило, выполняют с подогревом 60…200°C в зависимости от марки клея.
Монтаж кристаллов и подложек, предназначенных для работы в герметизированных корпусах, возможен только теми клеями, которые не содержат активных компонентов, способных при температуре эксплуатации выделяться из клеевой прослойки и заполнять объем корпуса. В связи с этим широкое применение находят клеи марок ВК-2, ВК-4, ВК-8 и ВК-9. Основные данные по клеям повышенной теплопроводности (в том числе и электропроводящим) для крепления кристаллов приведены в табл. 13.
Таблица 13. Свойства электро- и теплопроводящих клеев на эпоксидной основе.
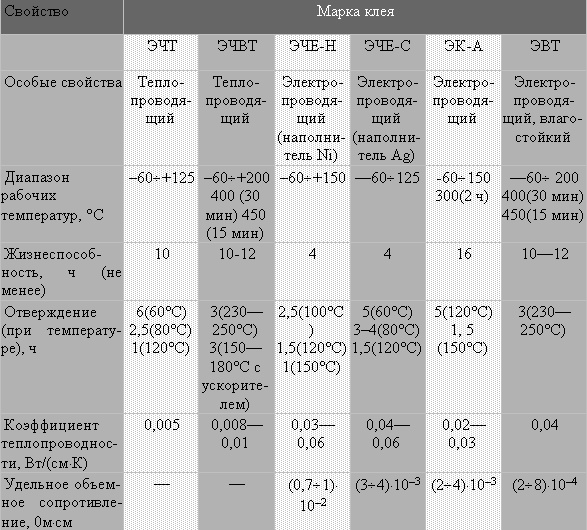
Качество поверхности соединяемых элементов оказывает большое влияние на прочность клеевого слоя. Поэтому с поверхностей перед склеиванием тщательно удаляют загрязнения и жировые пленки, причем следы используемых органических растворителей должны быть полностью удалены сушкой.
При отверждении клея остаточный растворитель создает пористость и внутренние напряжения, снижающие прочность слоя. Для удаления растворителей, входящих в состав клея, производят сушку на воздухе в течение 1-1,5 ч, после чего проводят термообработку в соответствии с выбранным режимом отверждения.
Прочность клеевого слоя в объеме зависит от совершенства структуры полимера. Количество дефектов увеличивается с толщиной слоя и прочность соединения падает. Рекомендуется слой ограничивать толщиной 0,05-0,1 мм.
Качество поверхности соединяемых элементов оказывает большое влияние на прочность клеевого слоя. Поэтому с поверхностей перед склеиванием тщательно удаляют загрязнения и жировые пленки, причем следы используемых органических растворителей должны быть полностью удалены сушкой.
При отверждении клея остаточный растворитель создает пористость и внутренние напряжения, снижающие прочность слоя. Для удаления растворителей, входящих в состав клея, производят сушку на воздухе в течение 1-1,5 ч, после чего проводят термообработку в соответствии с выбранным режимом отверждения.
Прочность клеевого слоя в объеме зависит от совершенства структуры полимера. Количество дефектов увеличивается с толщиной слоя и прочность соединения падает. Рекомендуется слой ограничивать толщиной 0,05-0,1 мм.
Точную дозировку по толщине и площади клеевого слоя обеспечивает применение пленочных клеев. Пленочные клеи представляют собой неполимеризованный подсушенный клей, который можно разрезать на заготовки нужных размеров и формы. Такие пленки выпускают специализированные заводы в виде непрерывных лент на основе различных клеев. Широкое применение для крепления подложек гибридных микросхем к основанию корпуса нашли, в частности, пленки на основе метилполиамиднофенольного клея МПФ-1. Непосредственно перед монтажом для активации поверхности заготовки пленочного клея ее погружают на 1-2 сек. в этиловый спирт. Далее установленные пленку и подложку помещают в прижимное приспособление с резиновой прокладкой, где выдерживают 1-2 мин. После сушки на воздухе не менее 30 мин. изделие подвергают термообработке в термостате (подъем температуры до 150°C в течение 1 ч, выдержка 2 ч, охлаждение вместе с термостатом до 30-40°С).
Пайка стеклами позволяет достичь хорошего согласования соединяемых материалов по ТКР, так как, варьируя состав стекла, можно изменять его ТКР в широких пределах. К легкоплавким стеклам относят обычно стекла, температура размягчения которых не превышает 550°С. Такие стекла имеют более высокий ТКР (С84-1, С88-1, С89-3, С90-1, для которых значения a соответственно равны (8,4; 8,8; 8,9 и 9,0)*10-6 K-1. Для часто используемых сочетаний материалов "ковар-ситалл, поликор, кремний" требуются стекла с ТКР порядка (5¸7)*10-6 K-1, т. е. тугоплавкие (например, С-50).
Использование относительно тугоплавких стекол практически исключает возможность припайки кристаллов стеклом на подложках гибридных пленочных микросхем и микросборок. Пайку стеклом в основном применяют для крепления керамических, поликоровых и ситалловых подложек. Наилучшая адгезия стекла и, следовательно, прочность соединения обеспечиваются с материалами, представляющими собой смеси окислов (ситалл, поликор, керамика 22ХС), или с металлами, имеющими на поверхности прочный слой окисла.
Технология пайки стеклом сводится к нанесению суспензии (пасты) стеклянного порошка в деионизованной воде на очищенную поверхность, сжатию соединенных деталей в приспособлении-кассете, сушке и последующему оплавлению в печи в контролируемой атмосфере.
Пайка металлическими сплавами обеспечивает высокую электропроводность соединения, механическую прочность, хорошее согласование по ТКР. Благодаря высокой теплопроводности и малой теплоемкости металлических сплавов, необходимое время для плавления и получения соединения достаточно мало, что делает целесообразным выполнение этих операций на специальных установках последовательного присоединения кристаллов с высоким уровнем механизации и автоматизации.
В качестве присоединительного слоя могут быть использованы мягкие припои, такие, как Аu-Sn (80 масс. %. и 20 масс. %; tпл =280°С), Рb-Sn-Аg (92, 5,5 и 2,5 масс. %; tпл =300°С) и др. Припой вводят в место соединения в виде фольговых дисков или наносят в виде пасты трафаретным способом. Необходимым условием качественного соединения является высокая смачиваемость соединяемых поверхностей припоем. Для этого кристаллы на установочной плоскости должны иметь слой металлизации (золото, серебро или никель с подслоем хрома), который наносят на этапе групповой обработки на обратную (нерабочую) сторону групповой пластины. Соответственно площадка для установки кристалла на подложку (или на основание корпуса) должна иметь никелевое или золотое покрытие.
Пайка мягкими припоями допускает при необходимости демонтаж припаянного кристалла. В то же время относительно низкая температура плавления припоя ограничивает технологическую температуру на последующих операциях присоединения выводов и герметизации микросхемы.
Более высокую температуру плавления (370°С) имеет эвтектический сплав Аu-Si (94 и 6 масс. %), который также в виде фольгового диска помещают между кристаллом и основанием. Для улучшения смачивания кристалла припоем целесообразны золочение поверхности кристалла, а также ультразвуковые колебания инструмента, прижимающего кристалл. Рабочую температуру устанавливают в пределах 390-420°C, т.е. выше температуры эвтектики. Время пайки 3-5 с, давление инструмента 1-З Н/мм2.
При пайке любыми эвтектическими сплавами температура плавления сплава невысокая (наименьшая для данной системы). Кристаллизация происходит одновременно по всему объему, т. е. скачкообразный переход из жидкой фазы в твердую обеспечивает мелкозернистость структуры слоя и, следовательно, повышенную прочность.
Разновидностью пайки эвтектическим сплавом Аu-Si является соединение кремниевого кристалла с золоченой поверхностью основания (подложки или корпуса) за счет контактного плавления без введения припоя (контактно-реактивная пайка). При использовании этого метода нижняя поверхность кристалла должна быть освобождена от пассивной пленки, что достигается стравливанием двуокиси кремния с групповой пластины до разделения. Соответствующие площадки на ситалловой или поликоровой подложке могут быть получены вакуумным осаждением золота. Площадку на основании металлического корпуса целесообразно формировать локальным гальваническим золочением. Позолоченные площадки на керамических подложках или основаниях корпусов получают вжиганием золотой пасты ПЗП-3 при температуре 950 °С.
При сжатии кремниевого кристалла с позолоченной поверхностью с усилием ~0,8 Н в условиях нагрева до 390-420 °С происходит взаимная диффузия (растворение в твердой фазе) золота и кремния. Вследствие плавного изменения концентрации компонентов по нормали к соединяемым поверхностям возникает слой, состав которого близок к эвтектическому. При температуре нагрева этот слой переходит в жидкую фазу. С момента возникновения жидкой фазы процессы диффузии и растворения ускоряются, а расплавленный слой быстро расширяется.
Поскольку все виды пайки металлическими припоями, включая пайку контактным плавлением, можно выполнять на механизированных установках, применение флюсов в этих условиях снизило бы эффективность использования таких установок. Поэтому пайку обычно производят в защитной или защитно-восстановительной среде путем подачи соответствующего газа через миниатюрное сопло в зону пайки. Этот же газ используют для охлаждения полученного соединения.
На площадку для пайки кристалл (а также припойный диск) устанавливают вакуумным пинцетом из кассет с ориентированными кристаллами. Этот же пинцет является инструментом, выполняющим соединение.
При укладке ориентированных кристаллов в кассеты (после скрайбирования, ломки групповой пластины и отбраковки дефектных кристаллов) требуется трудоемкая и утомительная ручная работа или специальные сортировочные автоматы с нежелательными механическими воздействиями на кристаллы. Поэтому представляют интерес различные приемы, позволяющие сохранить ориентацию кристаллов после ломки групповой пластины, один из которых заключается в том, что групповая пластина, прошедшая операции зондового контроля и скрайбирования, наклеивается на эластичную пленку. Ломка пластины производится прокатыванием ролика по поверхности пластины. Далее пленка на специальном приспособлении растягивается по двум осям (при этом кристаллы раздвигаются, сохраняя ориентацию) и в этом положении фиксируется. После подогрева пленки дефектные кристаллы удаляют вакуумным пинцетом, а остальные погружают в ванночку с растворителем, сушат и переносят в кассету. Описанный принцип лежит в основе работы установки ЭМ-226, производительность которой 40 пластин в час при их диаметре 80 мм.
Установки для пайки кристаллов (ЭМ-438А, ЭМ-438М) могут работать в автоматическом и полуавтоматическом режимах. В автоматическом режиме рабочий цикл непрерывно повторяется с определенным тактом, а кассета с корпусами (или отрезок ленты с выводами) перемещается с каждым циклом автоматически на определенный шаг. В полуавтоматическом режиме для выполнения очередного цикла необходим пуск установки оператором. Полуавтоматический режим используют при ручной установке корпусов на рабочую позицию, а также в процессе наладки установки.
Рабочий цикл включает в себя следующие приемы, выполняемые автоматически: захват кристалла инструментом (с вакуумным прижимом), включение нагрева инструмента, перемещение корпуса (ленты) на шаг, установка кристалла, выключение вакуума, включение ультразвукового генератора, пайка, выключение подогрева инструмента и ультразвукового генератора, включение обдува, подъем инструмента и выключение обдува.
Технические характеристики установки присоединения кристаллов ЭМ-438.
