6. Легирование методом термической диффузии примесей.
6.1. Условия возникновения p-n-перехода.
В подавляющем большинстве случаев легирующая примесь вводится в монокристаллический кремний с целью изменения типа проводимости и образования p-n-перехода на определённой глубине. Изменение типа проводимости имеет место в случае, если максимальная концентрация введённой примеси превышает концентрацию исходную (Nисх). Образование p-n-перехода происходит на глубине Хn, где концентрация введённой примеси оказывается равной исходной.

Рис. 6. Принцип образования p-n-перехода.
При термической диффузии (рис. 6) максимальная концентрация примеси всегда на поверхности (N0) и монотонно убывает с глубиной.
6.2. Факторы, определяющие скорость процесса диффузии
Как известно, диффузия атомов или молекул в любой среде (газовой, жидкой, твердой) описывается следующим уравнением (1-е уравнение диффузии):
 | (1) |
где J - плотность потока частиц, см–2×с–1;
Х – глубина проникновения частиц в направлении Х, см, (в рассматриваемом случае – по нормали к поверхности кристалла);
N - концентрация частиц (атомов примеси), см–3 .
Таким образом, множитель ¶N/¶X представляет собой градиент концентрации примеси [см–4] в направлении Х, а коэффициент пропорциональности D [см2×с–1] – коэффициент диффузии. С повышением температуры процесса коэффициент диффузии быстро (экспоненциально) возрастает, т.к. возрастает энергия атомов легирующей примеси. В плотной структуре оксидной маски (SiO2) коэффициент диффузии существенно меньше, за счёт чего и обеспечивается избирательность легирования.
При высокой температуре процесса (порядка 1000° С) атомы как исходной, так и вводимой примеси ионизированы и образуют электрическое поле, всегда ускоряющее процесс диффузии. Зависимость коэффициента диффузии (в логарифмическом масштабе) от t° и N0 при двух значениях Nисх приведена на рис. 7.
6.3 Функция распределения концентрации примеси по глубине.
Концентрация введённой примеси с глубиной меняется непрерывно, что описывается дифференциальным уравнением (уравнением непрерывности):
 | (2) |
Из уравнения следует, что в элементарном объёме кристалла толщиной ¶X и площадью в 1 см2 за время ¶t происходит накопление примеси (¶N>0), если плотность потока убывает (¶J<0), и наоборот.
Решая совместно уравнения (1) и (2) можно получить 2-е уравнение диффузии, отражающее протекание процесса диффузии во времени:

Рис. 7. Температурная зависимость коэффициента диффузии фосфора и бора в кремний, Nисх и N0 - исходная и поверхностная концентрации примеси, см.
 | (3) |
Решение уравнения (3) при определённых граничных условиях представляет собой функцию распределения N(x).
На практике используются два варианта проведения процесса: диффузия из постоянного внешнего источника и диффузия из конечного поверхностного источника.
6.4 Диффузия из постоянного внешнего источника (одностадийный процесс).
В этом случае внешний (вне рабочей камеры) источник постоянно поставляет к поверхности пластин-заготовок примесь в газообразном состоянии, причём её расход отрегулирован так, что на поверхности пластины поддерживается постоянная концентрация N0 , хотя примесь при этом поступает вглубь кристалла. Процесс выполняют до тех пор, пока p-n-переход не окажется на заданной глубине.
При N0=const решение уравнения (3) приводит к функции:
 | (4) |
где erfcV=1-erfV – дополнение функции ошибок erfV (до единицы), которое приведено в таблице 1.
Поскольку в данном случае может быть создана и выдержана до конца процесса предельно высокая концентрация на поверхности кристалла, этот одностадийный процесс рекомендуется для областей n+ и p+ (эмиттерные области в биполярных транзисторах, истоки и стоки МДП-транзисторов).
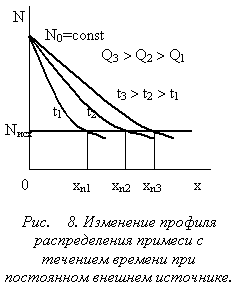 | Характер изменения профиля распределения примеси с течением времени приведен на рис. 8., из которого видно, что с течением времени p-n-переход углубляется. Для вычисления необходимого времени ведения процесса технологу должны быть заданы разработчиком физической структуры параметры Xn, N0 и Nисх. |
6.5 Диффузия из конечного поверхностного источника
(вторая стадия двухстадийного процесса).
В этом случае поверхность кристалла содержит определённое количество примеси на единицу площади, и процесс сводится к перераспределению (разгонке) её по глубине до тех пор, пока p-n-переход не углубится на заданную величину Xn. Таким образом, количество примеси, введённое предварительно в поверхностный слой, или доза легирования Q [см–2] сохраняется постоянной до конца процесса разгонки.
Таблица 1. Значения функции erfc V
| V | еrfcV | V | еrfcV |
| 0.0 | 1.00000 | 2.6 | 2.36×10-4 |
| 0.1 | 0.88754 | 2.7 | 1.343×10-4 |
| 0.2 | 0.77730 | 2.8 | 7.5×10-5 |
| 0.3 | 0.67135 | 2.9 | 4.11×10-5 |
| 0.4 | 0.57161 | 3.0 | 2.21×10-5 |
| 0.5 | 0.47950 | 3.1 | 1.16×10-5 |
| 0.6 | 0.39614 | 3.2 | 6.02×10-6 |
| 0.7 | 0.32220 | 3.3 | 3.05×10-6 |
| 0.8 | 0.25790 | 3.4 | 1.52×10-6 |
| 0.9 | 0.20309 | 3.5 | 7.43×10-7 |
| 1.0 | 0.15730 | 3.6 | 3.55×10-7 |
| 1.1 | 0.11979 | 3.7 | 1.67×10-7 |
| 1.2 | 0.08969 | 3.8 | 7.68×10-8 |
| 1.3 | 0.06599 | 3.9 | 3.48×10-8 |
| 1.4 | 0.04771 | 4.0 | 1.54×10-8 |
| 1.5 | 0.03389 | 4.1 | 6.7×10-9 |
| 1.6 | 0.02365 | 4.2 | 2.86×10-9 |
| 1.7 | 0.01621 | 4.3 | 1.19×10-9 |
| 1.8 | 0.01091 | 4.4 | 4.89×10-10 |
| 1.9 | 0.00721 | 4.5 | 1.96×10-10 |
| 2.0 | 4.678×10-3 | 4.6 | 7.74×10-11 |
| 2.1 | 2.971×10-3 | 4.7 | 2.99×10-11 |
| 2.2 | 1.863×10-3 | 4.8 | 1.13×10-11 |
| 2.3 | 1.143×10-3 | 4.9 | 4.21×10-12 |
| 2.4 | 6.89×10-4 | 5.0 | 1.53×10-12 |
| 2.5 | 4.07×10-4 | — | — |
При Q=const решение уравнения (3) приводит к функции:
 | (5) |
где Dp и tp – коэффициент диффузии и время процесса разгонки. При отсутствии внешнего источника примеси разгонка происходит при непрерывном уменьшении концентрации примеси на поверхности.
 Характер изменения профиля распределения примеси с течением времени приведен на рис. 9, из которого следует, что концентрация примеси на поверхности постепенно убывает, p-n-переход углубляется, а доза легирования Q, характеризуемая площадью под кривой распределения, остаётся неизменной.
Характер изменения профиля распределения примеси с течением времени приведен на рис. 9, из которого следует, что концентрация примеси на поверхности постепенно убывает, p-n-переход углубляется, а доза легирования Q, характеризуемая площадью под кривой распределения, остаётся неизменной.
Необходимая доза легирования Q обеспечивается на первой стадии процесса (загонка примеси) с постоянным внешним источником примеси:
 (6)
(6)
где D3 и t3 - коэффициент диффузии и время процесса загонки;
N03-концентрация примеси, поддерживаемая на поверхности пластины в течение процесса загонки.
Двухстадийный процесс рекомендуется для областей с умеренной концентрацией примеси на поверхности и относительно глубоких (базовые области биполярных транзисторов, изолирующие "карманы" в КМДП-структурах). По-прежнему разработчиком структуры должны быть заданы параметры Xn, N0 и Nисх, которыми должен обладать слой после второй стадии.
Двухстадийный процесс позволяет осуществлять контроль результатов после первой стадии и корректировать режим второй стадии.
6.6. Рабочая камера диффузионной печи.
Схема рабочей камеры диффузионной печи приведена на рис. 10.

Рис. 10. Схема рабочей камеры диффузионной печи.
Собственно камера представляет собой кварцевую (или керамическую) трубу 1, снабжённую резистивными нагревателями 2 (3 секции с независимым регулированием температуры). Крайние секции поддерживают малый градиент температуры, обеспечивающий средней секции рабочую температуру до 1250°С с высокой точностью (до ±0,25°С). Именно в этой части камеры на кварцевом (или керамическом) держателе 3 располагаются обрабатываемые пластины 4, имеющие на рабочей поверхности оксидную маску. При выполнении загонки примеси или одностадийного процесса диффузии в камеру из внешнего источника непрерывно подаётся диффузант, представляющий смесь легирующей примеси (акцептор бор или донор фосфор) с транспортирующим газом (аргон).
При разгонке примеси в двухстадийном процессе в камеру непрерывно подаётся только аргон, поддерживающий чистоту рабочей зоны. Побочные продукты процесса на выходе собираются специальными сборниками.
В зависимости от диаметра одновременно может обрабатываться до трёх десятков пластин. Технические характеристики диффузионной однозонной печи СДО-125/3-12 следующие:
| Количество технологических труб, шт. | 3 |
| Диапазон рабочих температур, °С | 700-1250 |
| Диаметр рабочей трубы, мм | 120 |
| Диаметр обрабатываемых пластин, мм | до 80 |
| Минимальная длина рабочей зоны (мм) с неравномерностью распределения температуры, °С ±0,25 ±0,5 | 450 600 |
| Стабильность поддержания температуры в пределах рабочей зоны, °С | ±0,25 |
| Воспроизводимость температурного уровня, °С | ±0,5 |
| Время выхода печи на максимальную рабочую температуру, ч | 2 |
| Максимальная мощность, потребляемая в установившемся режиме, кВт | 18 |
| Размеры, мм | 1852Х630Х2150 |
| Масса, кг | 800 |
6.7. Расчет режимов термической диффузии.
Вследствие того, что функции распределения носят приближённый характер, а коэффициент диффузии непостоянен по глубине кристалла, изложенная ниже методика расчёта режимов даёт лишь ориентировочное значение времени ведения процесса. По результатам контроля опытных образцов это время корректируется.
6.7.1. Двухстадийный процесс.
Рассматривая Гауссово распределение (5) на поверхности (Х=0) и на дне формируемого слоя (Х=Хn), можно получить выражение, связывающее режимы процесса (произведение Dptp) c заданными параметрами слоя (Xn , N0 , Nисх):
 | (7) |
Порядок проектирования режимов двухстадийного процесса следующий:
- По формуле (7) вычисляется произведение Dptp.
- Задается поверхностная концентрация примеси для этапа загонки, N0< N< Nпред. Для бора (акцептор) Nпред=2×1020 см-3, для фосфора (донор) Nпред=8×1020 см-3
- Задается температура загонки t°p из диапазона 1000÷1200°С.
- По графику зависимости D=f(t°, N03, Nисх) определяется Dp.
- Вычисляется время разгонки tp по результату п.1.
- По выражению (5) при Х=0 вычисляется необходимая доза легирования

- По выражению (6) вычисляется произведение

- Задается температура загонки t°3 из диапазона 800÷1000°С.
- По графику зависимости D=f(t°, N03, Nисх) определяется D3.
- Вычисляется время загонки t3 по результату п.7.
Итак, параметрами двухстадийного процесса являются N03, t°3, t3, t°р и tр.
6.7.2. Одностадийный процесс.
Рассматривая распределение примеси по закону дополнения функции ошибок (выражение 4) на дне формируемого слоя (Х=Хn), можно получить выражение, связывающее режимы процесса (Dt) с заданными параметрами (Xn , N0 , Nисх):
 | (8) |
Порядок проектирования режимов одностадийного процесса следующий:
- Задается N0= Nпред.
- Вычисляется N0/ Nисх.
- По результату п.2 с помощью таблицы erfcV определяется значение аргумента V.
- Вычисляется (по выражению 8)

- Задается температура процесса из диапазона 1000÷1200°С.
- По графику зависимости D=f(t°, N03, Nисх) определяется D.
- Вычисляется время процесса по результату п.4
Итак, параметрами одностадийного процесса являются N0, t° и t.