9. Оценка удельного поверхностного сопротивления легированных слоёв.
Понятие удельное поверхностное сопротивления слоя можно установить путём следующих рассуждений. Пусть легированная область представляет собой в плане прямоугольный элемент длиной l и шириной a при толщине d. Сопротивление такого элемента току, протекающему вдоль элемента, может быть определено по общеизвестной формуле  , где r [Ом×см] – удельное объёмное сопротивление материала области (слоя). Для элемента квадратной формы (l=a) его сопротивление
, где r [Ом×см] – удельное объёмное сопротивление материала области (слоя). Для элемента квадратной формы (l=a) его сопротивление  . Удельное поверхностное сопротивление Rсл, выражаемое в омах, является, таким образом, сопротивлением квадратного участка слоя независимо от размеров квадрата. Теперь сопротивление прямоугольного элемента может быть представлено в виде
. Удельное поверхностное сопротивление Rсл, выражаемое в омах, является, таким образом, сопротивлением квадратного участка слоя независимо от размеров квадрата. Теперь сопротивление прямоугольного элемента может быть представлено в виде
 | (25) |
т.е. как удельное поверхностное сопротивление Rсл, умноженное на число квадратов со стороной а, вписывающихся в элемент длиной l
Параметр Rсл широко используется для расчёта сопротивлений областей, в которых токи протекают параллельно плоскости кристалла: пассивная база и коллектор транзисторов, резисторы, межсоединения на поверхности кристалла.
При известной толщине полупроводникового слоя d=Xп задача определения Rсл в основном сводится к отысканию значения r. Удельное объёмное сопротивление r зависит от средней эффективной концентрации примеси Nср.эф. В свою очередь, Nср.эф определяется средней концентрацией введённой примеси за вычетом концентрации примеси, компенсированной примесью исходного слоя.
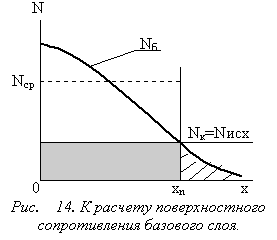 На рис. 14 приведено в качестве примера распределение примеси в базовом слое (Nб) и коллекторе (Nк = Nисх). Площадь под кривой Nб выражает собой полную дозу легирования
На рис. 14 приведено в качестве примера распределение примеси в базовом слое (Nб) и коллекторе (Nк = Nисх). Площадь под кривой Nб выражает собой полную дозу легирования 
В пределах рассматриваемого базового слоя присутствует лишь часть дозы введенной примеси
 | (26) |
где N(x)-функция распределения концентрации примеси.
Интегрирование согласно (26) приводит к следующим выражениям:
| для базового диффузионного слоя | |
 | (27) |
| для имплантированного слоя | |
 | (28) |
Для эмиттерного слоя, который используется при проектировании низкоомных (несколько десятков Ом) резисторов, ввиду высокой крутизны кривой N(x), можно принять Qn@ Q (на рис. 14 заштрихованная справа площадь становится пренебрежительно малой).
| Средняя концентрация введённой примеси в пределах 0…Хп | |
 | (29) |
| Средняя эффективная концентрация в слое | |
 | (30) |
| Средняя эффективная концентрация в слое | |
 | (31) |
где q=1,6×10-19 Кл- заряд электрона; m- подвижность основных носителей в слое, см2/(В×с).
Для кремния при Т=300 К подвижность электронов и дырок определяется соответственно по формулам:
 | (32) |
 | (33) |
Здесь NS=Nср+Nисх – суммарная концентрация примеси в слое.
Искомое значение удельного поверхностного сопротивления определяется по выражению:
 | (34) |