7. Легирование методом ионной имплантации.
7.1. Сущность и особенности процесса.
При ионной имплантации атомы легирующей примеси ионизируют в сильном электрическом поле и облучают потоком ионов поверхность пластины с подготовленной заранее оксидной маской (рис. 11). Имея при подлёте к поверхности одинаковую энергию, ионы при вхождении в кремний испытывают многократные столкновения с ядрами и кулоновское взаимодействие с электронами атомов кремния.Это приводит к постепенному торможению ионов вплоть до полной остановки. Путь, пройденный отдельным ионом в кристалле кремния (длина пробега), является величиной случайной и для совокупности ионов, внедрённых в кристалл, оценивается средним значением пробегов lср.

Рис 11. Принцип легирования ионной имплантацией.
Разброс отдельных пробегов относительно среднего значения оценивается средним квадратическим отклонением s.
Параметры распределения пробегов lср и s зависят от энергии ионов Е, а также от эффективного диаметра атома примеси (иначе говоря от порядкового номера z в периодической системе элементов). Чем выше Е и меньше z, тем больше lср и s (таблица 2).
В материале оксидной маски (SiO2), имеющей более плотную структуру по сравнению с кремнием, имеет место более сильное торможение ионов, благодаря чему лишь незначительное количество ионов пронизывает маску и внедряются в кремний. За счёт этого достигается избирательность легирования. При энергиях десятки и сотни килоэлектронвольт ион способен при столкновении с ядрами кремния вызывать массовые смещения атомов в междоузлия решётки. В результате нарушения структуры монокристалла большое количество внедрённой примеси оказывается пассивной, неспособной создавать подвижные носители заряда, а активная часть примеси создаёт носители с низкой подвижностью. Для восстановления нарушенного слоя и перевода всей внедрённой примеси в активное состояние прибегают к отжигу поверхностного слоя путём облучения коротким (порядка 1 мс) и мощным импульсом инфракрасного излучения.
Таблица 2. Параметры распределения ионов легирующих элементов в кремнии при ионной имплантации (Е [кэВ], lср [нм], s [нм]).

Преимущества ионной имплантации по сравнению с термической диффузией примеси сводятся к следующему:
- Процесс не требует нагрева пластин и, следовательно, не приводит к изменению параметров ранее сформированных слоёв (за счёт диффузионной разгонки).
- Так как ионный пучок перпендикулярен к пластине, размеры легированной области точно соответствуют размерам окна в оксидной маске.
- Количество введённой примеси точно дозируется (контролируется в процессе облучения).
Недостатком процесса ионной имплантации является то, что при постоянной энергии ионов невозможно получить глубоко залегающий переход с одновременным присутствием примеси на поверхности. В связи с этим на практике прибегают к одному из двух вариантов (рис. 12):

Рис. 12. Формирование глубоких профилей: а - ступенчатый процесс;
б - комбинирование имплантационной загонки с диффузионной разгонкой
- Ступенчатый процесс. Непрерывное и глубокое распределение примеси от поверхности до перехода обеспечивается несколькими ступенями легирования при различных энергиях, причём первый (глубокий) профиль обеспечивает заданную глубину залегания p-n-перехода Хn, а последний (у поверхности) - необходимую поверхностную концентрацию N0 (рис. 12,а).
- 2. Комбинированный процесс. Имплантационная загонка примеси при низкой энергии обеспечивает необходимую дозу легирования Q и присутствие примеси на поверхности, а диффузионная разгонка - заданную глубину залегания p-n-перехода Хn (рис. 6.12,б).
7.2. Функция распределения концентрации примеси по глубине и технологические режимы.
Если направление ионного потока не совпадает с главными кристаллографическими направлениями в монокристалле кремния, то распределение примеси по глубине подчиняется гауссову закону:
 | (9) |
Из выражения (9) нетрудно получить формулы для N0 (при Х=0), Nmax (при Х=lср) и Nисх (при Х=Хп):
 | (10) |
 | (11) |
 | (12) |
| Из (11) и (12) можно получить | |
 | (13) |
| а из (10) - условие, при котором поверхностная концентрация будет не менее заданной величины N0 | |
 | (14) |
Знаки "±" в формуле (13) отражают тот факт, что если профиль распределения лежит достаточно глубоко, то образуются два перехода (скрытый слой).
Выражения (11), (13), (14) используются при расчёте режимов имплантации. К ним относят: кратность ионизации атомов примеси n (иначе говоря, число единичных зарядов, которые несёт ион), ускоряющее напряжение Uуск [кВ] и доза легирования Q [см-2].
Первые два параметра связаны с энергией Е [кэВ] простым соотношением:
 | (15) |
| Доза легирования: | |
 | (16) |
где J - плотность ионного тока [A/см2], t - время облучения [c], q - заряд электрона (1,6×1019 Кл).
Из выражений (15) и (16) следует, что повышение кратности ионизации до 2 или 3 уменьшает необходимое ускоряющее напряжение для достижения необходимой энергии, но в то же время увеличивает длительность облучения (или плотность ионного тока) для достижения необходимой дозы легирования. Кроме того, получение потока 2х- или 3х -зарядных ионов требует повышения мощности, подводимой к разрядной камере установки. Таким образом, повышение кратности ионизации оправдано лишь в том случае, если рассчитанное при n=1 ускоряющее напряжение превышает возможности установки.
7.3. Рабочая камера установки ионной имплантации.
Установка ионной имплантации представляет собой вакуумную камеру, состоящую из ряда блоков, последовательно состыкованных с помощью уплотнений из вакуумной резины. Из источника примесь в парообразном или газообразном виде попадает в разрядный блок (ионизатор), из которого отрицательным потенциалом в 20…25 кВ ионы вытягиваются в магнитный сепаратор (масс-анализатор). Здесь в постоянном магнитном поле происходит разделение траекторий ионов с различным электрическим зарядом так, что в следующий блок проходит моноэнергетический поток ионов (с расчётным значением n). В этом блоке с помощью системы электродов ионному пучку придаётся плоская (ленточная) форма и в следующем блоке (ускорителе) ионы разгоняются до необходимой энергии. В рабочую камеру, таким образом, проходит плоский (ленточный) ионный луч, неподвижный в пространстве.
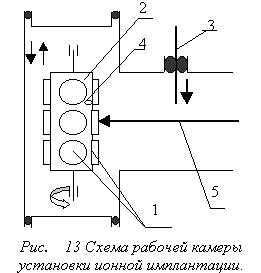 Схема рабочей камеры (последнего блока установки) приведена на рис. 13. Облучаемые пластины 1, несущие оксидную маску, размещаются по периферии держателя (контейнера) 2 в несколько ярусов. В процессе облучения пластин неподвижным ленточным лучом 5 контейнер вращается и совершает возвратно-поступательное движение. Пластины, таким образом, постепенно набирают необходимую дозу легирования. Между пластинами располагаются датчики 4, принимающие ту же дозу заряда, что и пластины. По достижении необходимой дозы (
Схема рабочей камеры (последнего блока установки) приведена на рис. 13. Облучаемые пластины 1, несущие оксидную маску, размещаются по периферии держателя (контейнера) 2 в несколько ярусов. В процессе облучения пластин неподвижным ленточным лучом 5 контейнер вращается и совершает возвратно-поступательное движение. Пластины, таким образом, постепенно набирают необходимую дозу легирования. Между пластинами располагаются датчики 4, принимающие ту же дозу заряда, что и пластины. По достижении необходимой дозы ( ) системой контроля вырабатывается сигнал, отключающий ионный луч.
) системой контроля вырабатывается сигнал, отключающий ионный луч.
Перед выгрузкой контейнера с обработанными пластинами вакуумный затвор 3 отсекает рабочую камеру от остального объёма установки, камеру открывают и производят замену контейнера с пластинами. После закрытия камеры и открывания затвора вакуумные насосы восстанавливают рабочее давление (примерно 10-4 Па) в объёме установки и начинается следующий цикл обработки.
Технические характеристики установки ионной имплантации "Везувий-9" следующие:

7.4. Расчет режимов ионной имплантации.
Наиболее полный набор задач расчёта режимов даёт вариант ступенчатой имплантации. В этом случае расчёт состоит из трёх этапов (см. рис. 12,а):
- Расчет режимов первой (глубокой) ступени имплантации, имеющей целью сформировать p-n-переход на заданной глубине Хп при заданных максимальной Nmax и исходной Nисх концентрациях.
- Расчет режимов для последней (приповерхностной) ступени, имеющий целью обеспечить поверхностную концентрацию не ниже заданной N0 (при тех же значениях Nmax и Nисх). Ограничение N0 снизу связано с необходимостью получения омического контакта к слою. (При низких, порядка 1017см-3 , значениях N0 возникает потенциальный барьер - барьер Шоттки).
- Расчет режимов для промежуточных ступеней, имеющих целью формирование непрерывного легированного слоя от поверхности до p-n-перехода.
Алгоритм расчёта третьего этапа достаточно сложен, поэтому ограничимся рассмотрением алгоритмов расчета первых двух.
Исходными параметрами слоя являются: глубина залегания p-n-перехода Хп, поверхностная концентрация N0 , исходная концентрация Nисх и максимальная концентрация Nmax . Следует подчеркнуть, что в отличие от диффузионной области, ограниченной p-n-переходом, имплантированная область имеет плавный переход только в донной части. "Стенки" области представляют ступенчатый p-n-переход, на котором пробивное напряжение минимально на глубине lср. Поэтому разработчик структуры ограничивает величину Nmax сверху
Для первой (глубокой) ступени расчёт сводится к следующему:
- Подобрать значения lср и s, удовлетворяющие равенству (13).
- По значениям lср и s для выбранного легирующего элемента из табл. 2. определить необходимую энергию Е [кэВ].
- По выражению (15) при минимально необходимом значении n (1,2 или 3) вычислить ускоряющее напряжение Uуск [кВ].
- По выражению (11) вычислить необходимую дозу легирования Q [см-2]
Для последней (приповерхностной) ступени:
- По выражению (14) вычислить отношение lср/s.
- Из табл. 2 найти значения, lср и s, дающие отношение, возможно более близкое к вычисленному.
- Установить по табл. 2 соответствующее значение энергии Е.
- По выражению (15) вычислить Uуск.
- По выражению (11) вычислить Q
Если в структуре ИМС предусмотрены высокоомные имплантированные резисторы, формируемые одновременно с последней ступенью, то для проектирования их топологии необходимо знать глубину залегания Хп' p-n-перехода, который образуется последней ступенью (см. рис. 12,а). Эта глубина рассчитывается по выражению (13) с подстановкой lср и s для последней ступени.